在一文贯通半导体芯片全产业链上篇文章中,我们为大家介绍了半导体芯片产业链的整体结构,按照上中下游的产业逻辑可划分为:
上游是半导体生产材料、生产设备及设计工具等支撑性领域。
中游是最为核心的芯片制造环节,包括芯片设计、晶圆制造和封装测试三大工序。
下游则是消费电子、计算机、汽车等芯片等终端应用方。
半导体芯片产业链示意图

在上一篇文章中,我们从产业链中游切入,讲解了其中芯片设计和晶圆制造的主要步骤——这两个环节如同给芯片“画图纸”,再在硅片上 “建城市”,通过层层精密工艺搭建起芯片的立体结构。
本篇我们续讲解中游的封装测试环节。
【中游环节3】封装测试:给芯片“穿外套”+“做体检”
芯片制造完成后,就是封装测试环节(后道工艺),它就像给芯片“穿外套”+“做体检”,先通过封装为芯片提供保护、电气连接、散热等功能,再通过测试筛选合格产品,这既是芯片制造环节的最后一步,也是保障其可靠性的关键一步。
封装后芯片示意图
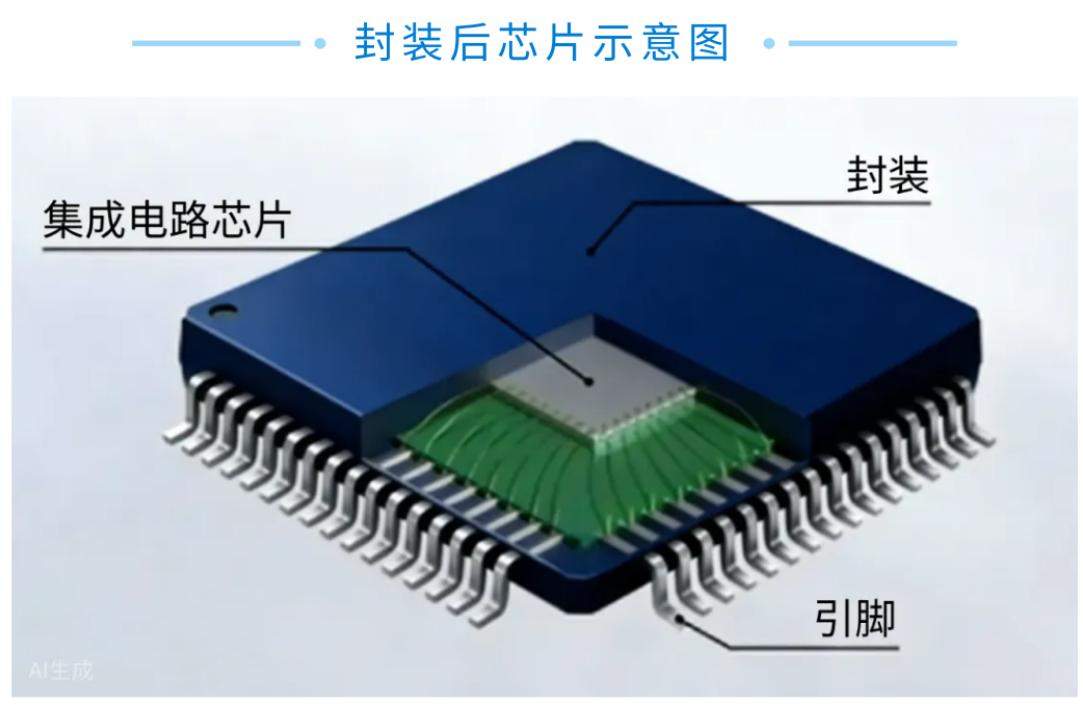
封装测试环节中,封装环节涉及的工艺较为复杂多样,是我们的重点关注方向,其主要分为传统封装与先进封装两大类。
传统封装覆盖大多数中低端芯片制造场景,大致流程是:
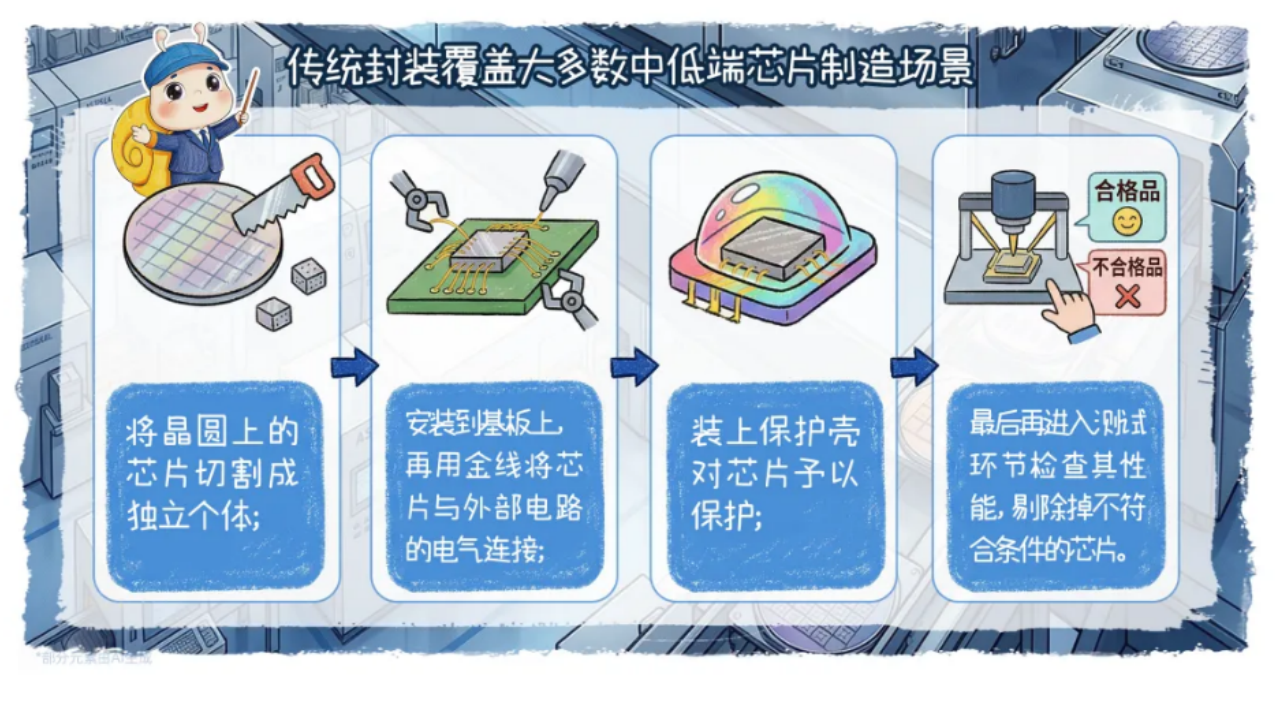
1、将晶圆上的芯片切割成独立个体;
2、安装到基板上,再用金线将芯片与外部电路的电气连接;
3、装上保护壳对芯片予以保护;
4、最后再进入测试环节检查其性能,剔除掉不符合条件的芯片。
先进封装聚焦高端芯片领域,主要是通过更高效、灵活、紧凑的方式,连接芯片和芯片内的各个部分,从而整体提升芯片的性能和功能,工艺上包括倒装封装、晶圆级封装、2.5D/3D 封装等。随着半导体先进制程向纳米级及以下迈进,先进封装市场在快速增长。

→封装测试对应的上游环节
与半导体前道工艺许多的材料设备环节被海外垄断、国内竞争力偏弱有所不同,我国在后道工艺的设备与材料环节具备一定的国际竞争力。
支撑封装测试的上游环节同样可以从材料和设备的维度去拆分。
封装测试主要材料设备介绍表

封装材料包括封装基板、引线框架、键合线,这三大材料已占据全球封装材料超80%的市场规模。
封装设备中,固晶机、划片机和键合机是最主要的设备,三大设备也是占据了全球封装设备市场超80%的规模。
半导体测试设备主要包括测试机、探针台和分选机,三大设备占据我国测试设备市场几乎所有的规模。
资料来源:SEMI,开源证券研究所、东吴证券研究所、观研报告网《中国半导体测试设备行业发展深度分析与投资前景预测报告(2025-2032年)》,华创证券,以上数据截止至2024年。
下游应用:丰富多元
半导体芯片行业的下游比较好理解,就是各类终端需求。半导体芯片的应用场景广、市场需求旺盛,大家耳熟能详的新能源车、消费电子、网络通信等行业,都对其有着广泛且多元的需求,已成为现代科技产业不可或缺的基石。
近年来,随着AI的应用领域不断延展、向各行各业持续渗透,市场对芯片的算力及能效要求也在不断攀升,可以预期未来高性能芯片的市场需求将与日俱增。根据Precedence Research预测,到2029年,全球AI芯片市场规模将从2024年的730亿美元增至2610亿美元。
全球AI芯片市场规模(十亿美元)

从上游的材料设备打底,到中游设计、制造、封测的配合,再到下游各类终端的广泛应用,关于半导体芯片产业链的全貌,我们就介绍到这里啦~
展望未来,随着下游应用场景的全面开花,相信半导体行业还将有非常广阔的发展空间。
我们会持续关注半导体行业的各类干货知识,敬请关注!
声明:本资料仅用于投资者教育,不构成任何投资建议。我们力求本资料信息准确可靠,但对这些信息的准确性、完整性或及时性不作保证,亦不对因使用该等信息而引发的损失承担任何责任,投资者不应以该等信息取代其独立判断或仅根据该等信息做出决策。基金有风险,投资须谨慎。
本资料版权为易方达基金所有,所载文字、数据和图表等未经易方达基金书面许可,任何单位或个人不得以转载、复制、改编、二次创作等任何形式使用本资料。对于任何侵犯本资料版权的行为,易方达基金将保留依法追究侵权者法律责任的权利。













